
全国服务热线:4009309399
电话:13418481618
工厂:深圳市光明新区玉律村美景产业园18-1栋3楼
网址:http://www.cnpcba.co/
邮箱:[email protected]
BGA是smt加工中很多高精密的电路板都会出现的最小焊点封装,而BGA那么小,我们锡膏量要控制以外,如何加固BGA使得更加牢固呢?无铅焊料降低了BGA封装的可靠性,特别是抗冲击与弯曲性能。采用传统的底部填充工艺需要花费更多的时间,而采用角部点胶工艺可以有效增强BGA的抗冲击与弯曲性能。
其中BGA的角部点胶工艺方法有两种:
1.再流焊接前点胶工艺
1) 工艺方法:焊膏印刷→点胶→贴片→再流焊接。
2) 工艺材料:要求胶水在焊点凝固前具有良好的流动性以便使BGA能够自动对位,也就是具有延时固化性能。市场上已经开发出来的BGA角部固定胶有很多,如Loctite309,应根据使用的焊料熔点进行选择。
3) 工艺要求
(1) 前提条件:BGA焊球与边的最小距离在0.7mm以上。
(2)角部L形点胶,长度为2-6个BGA球间距。涂4个焊球长度胶黏剂,焊点抗机械断裂提高18%;涂6个焊球长度胶黏剂,焊点抗机械断裂提高25%
(3) 贴片后胶水与焊盘距离大于等于0.25mm。
2.再流焊接后点胶工艺
1)工艺方法:焊膏印刷→点胶→贴片→再流焊接→点胶,采用手工点胶,使用的针头直径应满足图1的要求。
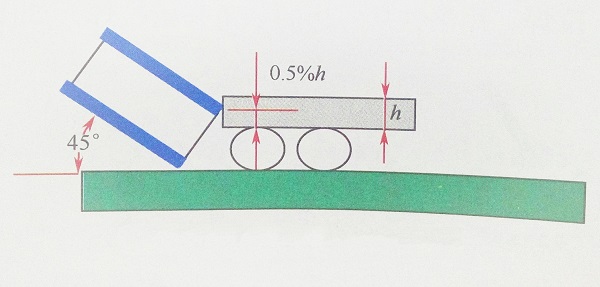
2)工艺材料:loctite309
3)工艺要求:工艺灵活,适用于任何BGA.